技术以及应用原子层沉积法(ALD:Atomic Layer Deposition)
这是一种通过在原子层级别控制膜厚,从而形成平整致密薄膜的技术。无论是像硅晶圆这样的平面基板,还是高深宽比的立体结构,都能涂覆均匀的薄膜。本文将从ALD法的特征性基本原理和关键词出发,对薄膜的特性(如覆盖性等)进行说明。
成膜原理:自限性
自限性(self-limiting)是ALD镀膜的关键特征。本文以三甲基铝(TMA: Al(CH3)3)为例进行说明。
- ①当引入的TMA分子接近羟基(OH)时,
- ②TMA中的Al(图中●)与甲基(CH3)基的C(图中●)之间的键会变弱,CH3基会试图与OH基的H原子 (图中●)结合,Al则会试图与OH基的O原子(图中●)结合。
- ③当两者进一步接近时,CH3基与H原子结合形成甲烷(CH4)并脱离基板,而Al则与O原子形成共价键并附着在基板上。
- ④若在步骤③中,基板表面被形成的Al(CH3)2和(CH3)Al<层填满,随后到达的TMA将无法发生反应而被排出。
也就是说,由于缺乏作为反应对象的OH基,后续到达的TMA无法参与成膜而被”吹走”。像这样,在形成单原子层或单分子层后,阻碍后续前驱体(原料)的反应和膜生长,这种现象被称为“自限制”。
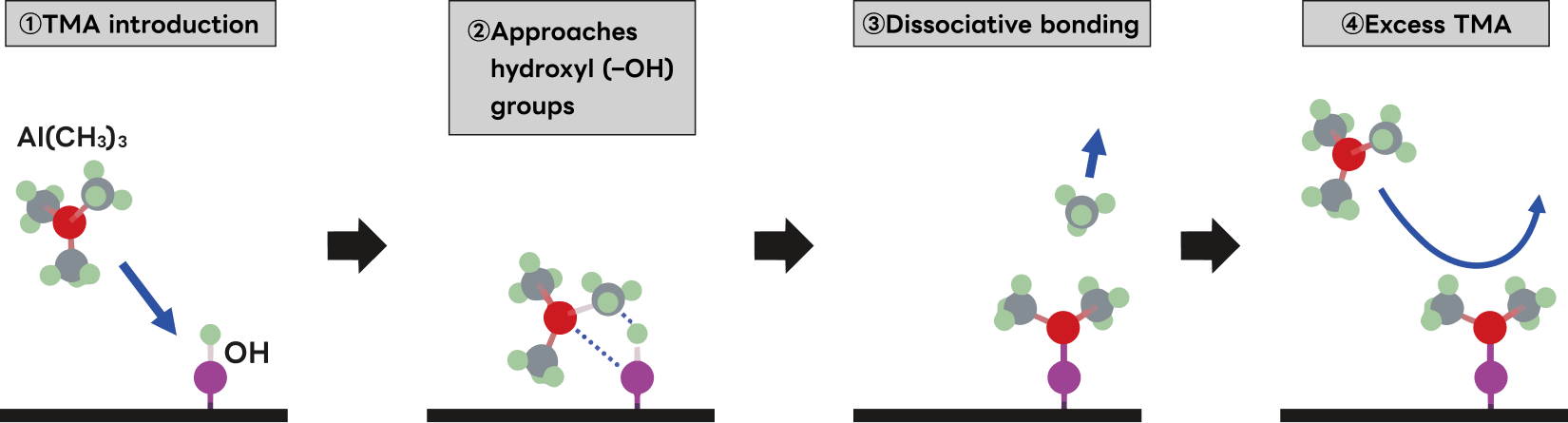
成膜过程:脉冲(数字)生长
ALD与其他镀膜的区别在于,它通过4个脉冲过程形成一层原子层/分子层,通过重复这个成膜循环,膜层逐渐变厚。因此,ALD法也被称为脉冲成膜法、数字成膜法或逐层成膜法。在此,我们将以使用三甲基铝(TMA: Al(CH3)3)作为前驱体、水作为反应气体制备的氧化铝膜为例,来解释这一独特的成膜过程。
- ①前驱体引入
像硅晶圆这样的基板会与大气中的水分子发生反应,在晶圆表面形成羟基(OH)。当引入的TMA接近晶圆表面时,TMA的甲基(CH3)会从Al原子上解离,从OH基中抽取氢原子形成甲烷(CH4),并离开晶圆。另一方面, 与CH3基断开键合的Al会与晶圆上残留的O原子形成新的Al-O键。 - ②吹扫
在通入N₂或Ar等惰性气体的同时,排出(抽除)上述工艺中未用于薄膜生长的多余TMA及副产物CH4。 - ③引入反应气体
待多余的TMA和副产物CH4完全清除后,引入水。当水分子(H₂O)接近与Al原子结合的CH3基时,会分解为H和OH;H与CH3基反应形成CH4,而OH与Al原子反应,以Al->OH的形式终止Al原子(形成膜表面)。这个时候”>”指在表面Al原子与其他基团之间存在2个化学键。此时,即使进一步引入水分子,也不会与OH基发生反应,因此会被直接排出。与①的工艺相同,此处也发生了自限制现象。 - ④吹扫
在通入N₂或Ar等惰性气体的同时,将上述过程中未反应的剩余H₂O及副产物CH4排出。
综上所述,经过①至④的工艺,晶圆被-Al(OH)2和>AlOH膜覆盖。随后,通过重复①至④的工艺,形成膜表面由OH基终止的Al₂O₃薄膜。
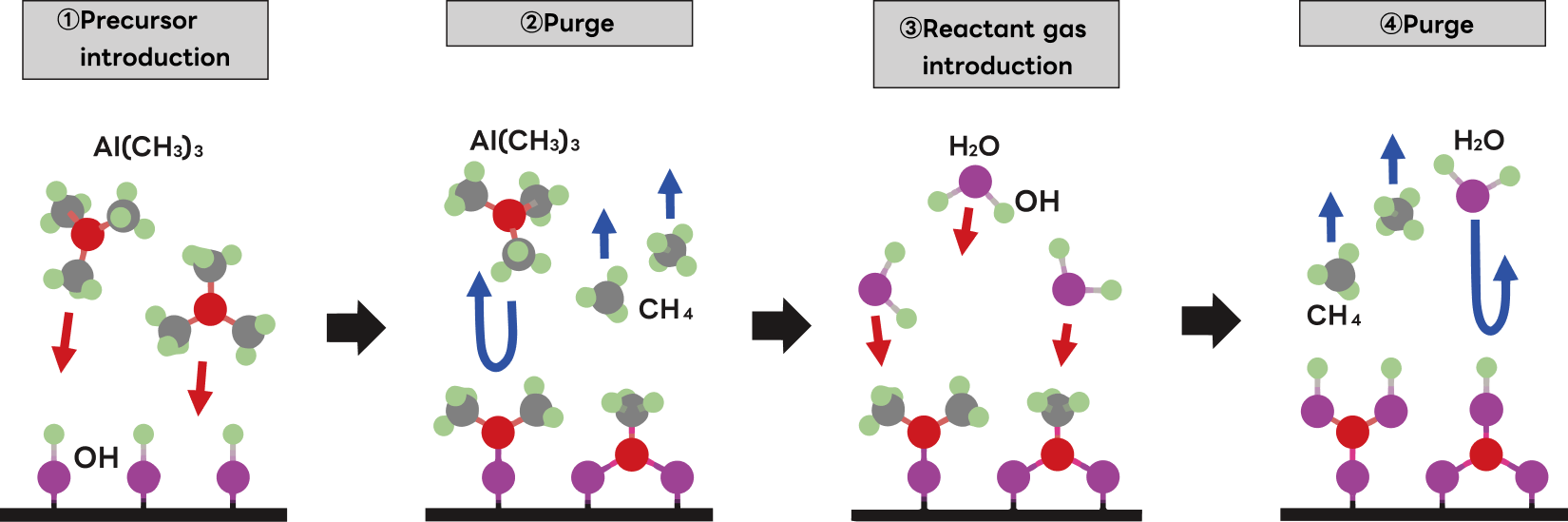
ALD的特点
上述成膜工艺及形成的薄膜具有以下特点:
- ・能够针对复杂的立体结构或纳米级表面(高AR沟槽、空隙、台阶)进行均匀(膜厚、膜质)的成膜。
图示为与其他方法的对比。溅射法因膜前驱体的直进性较强,容易产生阴影,且不擅长对狭窄区域进行涂覆。此外,等离子体CVD法虽能适应复杂形状,但在高长宽比且狭窄的微孔内壁上进行涂覆则较为困难。 - ・成膜成分接近化学计量比,致密度极高,可形成无针孔的薄膜。
- ・由于与成膜基材形成强力共价键,因此对基板及基材的附着力极高。
- ・作为一种可重复性高的工艺,能够严格控制膜厚。
- ・与其他方法相比,可在较低温度下进行成膜。

ALD窗口
ALD成膜特有的自调控性,是通过优化气体流量、脉冲时间、压力、温度等多种工艺参数而实现的。这种自调控性成立的参数调整范围被称为ALD Window(窗口)。在ALD窗口内,通过前驱体蒸汽的依次自饱和化学吸附形成薄膜的过程占据主导地位。
- ・当温度低于ALD窗口时,到达基板或薄膜表面的前驱体会与随后到达的前驱体形成分子间键,从而形成薄膜层。由于这种凝聚反应在低温下更容易进行,因此温度越低,膜厚越大。聚集反应还包括气相蒸汽的非受控物理吸附。必须避免引发物理吸附的工艺条件。另一方面,由于目标表面化学反应在低温下难以进行,表面反应总是需要活化能,而这一能量通常通过足够高的工艺温度或由等离子体产生的活性物种来提供。因此通过解离性结合反应形成的化合物薄膜的生长速度在低温下会越慢。
- ・当温度高于ALD窗口时,气相中的前驱体会分解并引发连续的化学反应,导致薄膜在缺乏自控的情况下生长。与此相反,抵达表面的前驱体也可能在发生化学反应之前就脱离并被排出。此外,在某些情况下,前驱体蒸汽可能会刻蚀薄膜表面,从而阻碍薄膜的生长。
- ・即使在ALD Window范围内,根据温度不同,材料也会从非晶相转变为晶相从而提高密度,因此也存在温度升高导致膜厚变薄的情况。
ALD Window会因前驱体、反应气体、等离子体源、基板温度、真空装置的排气性能等多种工艺条件而发生变化。

前驱体与反应源种类对膜质及膜生长的影响
以SiNx膜为例,概述前驱体和反应源种类对单个循环中膜生长的影响。首先,将前驱体分为
- (ⅰ)含氯的(SiH2Cl2、Si2Cl2等)、
- (ⅱ)含碳的(3DMAS: SiH(N(CH3)2)3, BTBAS: SiH2(NHtBu)2等)、
- (ⅲ)不含氯和碳的(SiH4、TSA: (SiH3)3N、NPS: (SiH3)4Si等)
这三类,并进一步分为热ALD和等离子体ALD。
各组所得的膜质如下:
- ・前驱体(ⅰ)因价格低廉、稳定性高而被广泛使用,相关研究案例也较多。但存在氯作为杂质混入薄膜的问题。请注意,六氯乙硅烷(Si₂Cl₆)必须谨慎处理,因为当它与水蒸气在排气管道中反应时,可能会生成爆炸性的固体化合物。
- ・前驱体(ⅱ)虽不含氯,但碳会混入膜中。不过,在特定条件下,碳混入量仅约2at.%,可制备出高密度且高折射率的SiNx。
- ・前驱体(ⅲ)不存在氯和碳混入膜中的风险,且TSA和NPS因每分子Si浓度较高,预计可提高膜生长速率。在采用TSA的研究中,已报道了高密度、高折射率的SiNx膜,此外虽然密度和折射率略有下降,但可在低温下合成。
同一研究组使用相同材料却得到截然不同的薄膜生长结果和膜质,这是由于基板温度、反应气体种类、等离子体源等因素存在差异所致。也就是说,为了获得理想的膜质,必须对前驱体、反应气体种类、热源/等离子体源、基板温度、前驱体引入/吹扫时间、真空装置(有效排气性能)等众多工艺参数进行优化。
(引用文献) X. Meng et al., Materials 9, 1007 (2016).
M. Zeghouane et al., Materials Science in Semiconductor Processing 184, 108851 (2024)
V. Miikkulainen et al., J. Appl. Phys. 113, 021301 (2013)
https://publications.vtt.fi/julkaisut/muut/2013/Crystallinity_of_inorganic_films.pdf

前驱体
如ALD Window中所述,为维持自控性,工艺条件存在一定限制,因此前驱体的选择与处理至关重要。目前,多家材料制造商已推出适用于成膜工艺的前驱体。下文仅列举部分正在研究或销售的ALD用前驱体作为示例。
| 化合物 | 化学式 |
|---|---|
| 卤素 | WF₆ |
| TiCl₄ | |
| HfCl₄ | |
| SnCl₄ | |
| 烷基 | (CH₃)₃ Al: TMA |
| (C₂H₅)₂ Zn: DEZ | |
| 烷氧基 | Al(OCH₃)₃ |
| Ta(OC₂H₅)₅ | |
| Ti(OCH(CH₃)₃)₄:TTIP | |
| 烷基酰胺 | Ti(N(CH₃)₂)₄: TDMAT |
| Zr(N(CH₃)(CH₂CH₃))₄: TEMAZ | |
| Ta(N(CH₃)₂)₅ | |
| 二酮酸盐 | Cu(C₅HF₆O₂)₂: Cu(hfac)₂ |
| Ni(C₅H₇O₂)₂: Ni(acac)₂ | |
| Zr(C₁₁H₁₉O₂)₄: Zr(tmhd)₄ |

等离子体源
在溅射法和PECVD法等成膜方法中,有些是利用等离子体的。通过利用等离子体所具有的高能量,可以制造出自然界中不存在的化学物质,或赋予其优异的功能性。
等离子体的发生源多种多样,在此介绍三种广泛应用的类型。
- (1)电容耦合等离子体 (Capacitively Coupled Plasma: CCP)
两块电极中的一块连接至高频电源,另一块则接地。电极间产生的电场会使部分原子或分子分解为电子和离子。这种电离气体被称为电容耦合等离子体。 - (2)感应耦合等离子体 (Inductively Coupled Plasma: ICP)
向线圈通入高频电流,会在线圈周围产生波动的磁场。该磁场通过介电体(窗口)渗透到真空腔内,而真空中的电子会呈涡状运动以抵消该磁场。这种感应电流被称为涡流。由于磁场变化而加速的电子与周围的原子或分子发生强烈碰撞,导致原子和分子 的一部分解离成电子和离子。这种电离气体被称为感应耦合等离子体。 - (3)电子回旋共振等离子体 (Electron Cyclotron Resonance plasma: ECR plasma)
电子和离子等带电粒子会像缠绕在磁力线上一样旋转着移动。电子比离子轻得多,因此旋转速度更快;当向等离子体中照射与电子旋转周期频率相同的电磁波时,只有电子会被强烈加速(共振加速)。通常使用微波(2.45GHz),此时的共振磁场强度为875G。

不同反应源对膜质/膜厚均匀性的影响
虽然利用等离子体中存在的电子、离子、激发态分子和自由基具有的高化学反应性来形成薄膜,但正因其高反应性,仅与周围的原子分子或壁面发生碰撞就会释放能量;若是离子,则会因接受电子而变为中性,导致所需的化学反应无法发生(称为失活)。因此,等离子体生成的活性物种若周围存在大量粒子(高压)或处于狭窄空间中,便容易失活,如图所示,狭窄沟槽侧壁底部附近的薄膜会比其他位置更薄。为此,虽然可以通过延长等离子体照射时间来完成沟槽底部附近的化学反应,但若纵横比(AR)较高,或受反应体系及反应气体种类的影响,有时实现起来极为困难。
尽管等离子体ALD方法具有高度通用性,并具备高速沉积和低温成膜等特点,但在涂覆高深宽比沟槽的内壁时,其与热ALD相比,在侧壁实现均匀膜厚的能力较差。
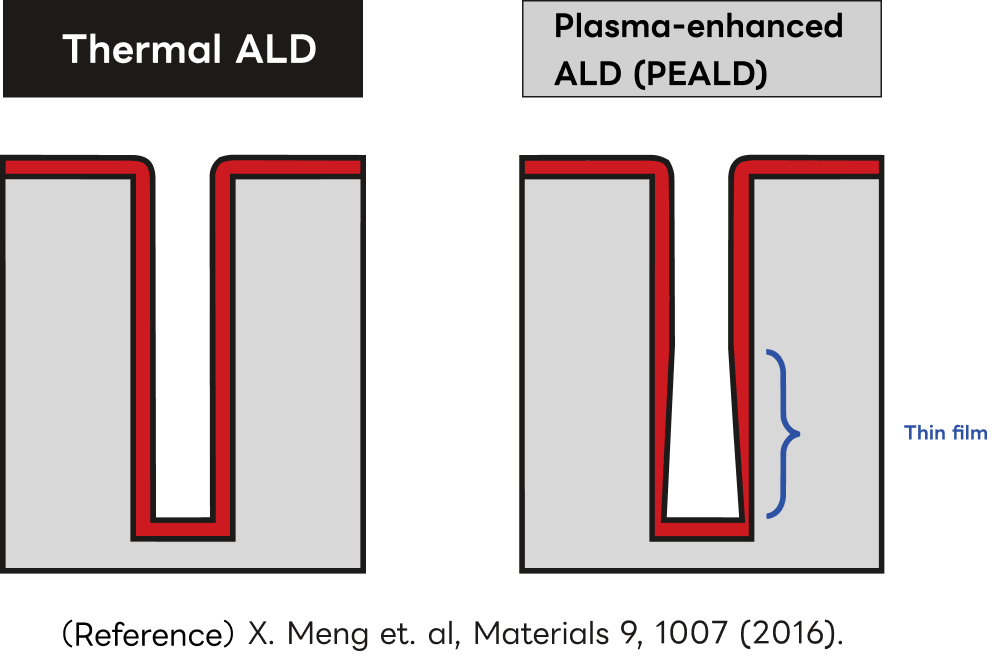
总结
利用自控性的ALD法是一种卓越的薄膜形成技术,通过重复四个工艺步骤,可在原子层级别上精确控制膜厚。此前,由于需要将这四个步骤分开进行,导致成膜时间较长,因此一直被认为不适合工业应用。然而,随着等离子体技术的引入,成膜速度得以提升;加之能够同时处理大量晶圆的大型量产设备的开发与制造,ALD技术已成为半导体器件、MEMS/NEMS等纳米技术领域中不可或缺的薄膜制造技术。
