技術と応用ドライエッチング
ドライエッチングの原理
エッチング加工はウェーハ上に所望の回路やパターンを作り出すための微細加工処理になります。
それは大体においてレジスト・マスクを形成した後に行なわれるので、プロセス上はリソグラフィーと一対になっており、広義リソグラフィーの後半プロセスと言うことができます。
エッチングプロセスは微細加工(マイクロメーター~ナノメーター級の加工)が可能であり、半導体、フラットパネル(ディスプレイ)、MEMS、光学デバイス等、様々なデバイス製作工程において、必要不可欠なプロセスです。
エッチング加工は、主に、以下の2つの方法に大別されます。
- ➢ウェットエッチング: 薬品溶液内で行うエッチングプロセス
- ➢ドライエッチング: 真空容器内の放電プラズマ中や反応性ガス中で行うエッチングプロセス
以下に、典型的なドライエッチ装置の構成と装置内におけるエッチングメカニズムに関る現象を示します。
装置内部には一対の平行円板電極が設けられ、一方の電極表面上にウェーハが載せられてRF 電圧が印加され、他方の電極は設置電位でまたその表面に設けられたシャワーヘッドから反応ガスが供給されます。
電極間では放電によりプラズマが発生し、ガス分子が励起されてエッチング作用を果す活性ラジカルやイオンとなります。
活性ラジカルとウェーハ表面における化学反応によりエッチング生成物が生じて表面から脱離する。
電極とプラズマの間には短い間隔のオンシースが生じて電極表面のウェーハを陽イオンで衝撃するが、これはラジカルの起こす化学反応や反応成生物脱離を促進したり、スパッタエッチングを起こします。脱離した反応成生物はガスとなり真空容器内から排気されます。
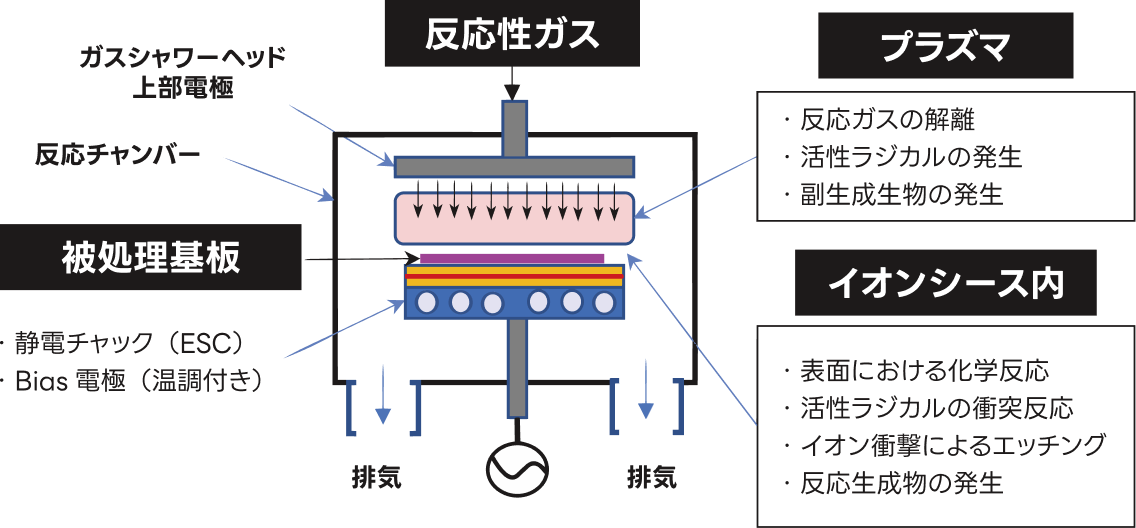
| ウェットエッチング | ドライエッチング | 備考 | |
|---|---|---|---|
| エッチング速度 | 速い | 遅い | |
| エッチング均一性 | 悪い | 良い | Wetエッチングは基板面内のエッチング均一性の制御が難しい |
| プロセス再現性 | 悪い | 良い | |
| エッチングの終点検出 | 出来ない。 | 可能(プラズマ発光、イオン質量分析、レーザー膜厚計等) | エッチングの終点を検出して所定のエッチング深さにエッチング可能(再現性が良い) |
| CDロス(マスクパターン線幅-エッチング後のパターン線幅) | 大きい | 小さい | Wetエッチングはレジストの下側もエッチングが進行しCDロスが大きい |
| フォトレジストに対する選択比 | 高い | 低い | Dryエッチングはプラズマによるフォトレジストの後退が発生する。 |
| エッチング形状の制御性 | 悪い | 良い | Dryエッチングは処理圧力やガス種、プラズマ中のイオンの制御によりエッチング形状の制御性が高い |
| 多層膜エッチング | 困難 | 可能 | エッチング条件を膜に応じて切り替え可能(多層膜一括エッチング) |
| エッチングの進行状況 | 等方性 | ①非等方性(物理エッチング)や ②等方性(化学エッチング)等の制御可能 |
|
| 環境への負荷 | Wetエッチング装置は酸廃液やアルカリ廃液が発生→ 環境負荷が大きい | 廃液の発生が無く環境負荷が少ない。 排ガスはプラズマによる分解や除害装置で除去 |
SDGsへの対応としてDryエッチング装置はメリットが有ります。 |
| エッチング形状 | サイドエッチング, アンダーカット 
|
①垂直形状

②テーパー形状

|
Dryエッチングの場合、垂直形状から、テーパー形状まで、エッチング形状を制御する事が可能。エッチング対象膜の要求に応じて、ガス種、処理圧力、RFパワー、処理温度等の調整を行い、形状を調整します。 |
エッチング源とプロセスパラメーター
エッチング源とプロセスパラメーター
ドライエッチングには、以下の様な様々なプラズマ源が使用されますが、ICP(誘導結合プラズマ)を使用したものが主流となっています。
理由は、プラズマ分布の制御が行いやすく、低圧力で、高密度なプラズマが生成可能で、エッチング速度の向上と、エッチング形状の制御が行いやすい為です。
但し、エッチングの用途に合わせて、容量性プラズマ(CCP)や、マイクロ波プラズマ、イオンビームエッチング等もプラズマ源として使用されます。
| エッチング源 | プラズマエッチング (PE Mode) |
容量性プラズマRIE (CCP-RIE) |
誘導性プラズマRIE (ICP-RIE) |
マイクロ波プラズマ (MW Plasma Etch) |
イオンビームEtch (IBE) |
|---|---|---|---|---|---|
| プラズマ密度 [cm-3] | ~1E+10 | ~1E+10 | ~1E+12 | ~1E+12 | ~1E12 |
| 圧力範囲 [mTorr] | 1000~100 | 500~10 | 100~1 | 1000~100 | ≦ 0.1 |
| 基板へ飛来するイオンエネルギー | 低い | 中間 | 高い | 中間 | 高い |
| 参考図 |

|

|

|

|

|
イオンビームエッチングのメカニズム
エッチング加工はウェーハ上に所望の回路やパターンを作り出すための微細加工処理になります。
それは大体においてレジスト・マスクを形成した後に行なわれるので、プロセス上はリソグラフィーと一対になっており、広義リソグラフィーの後半プロセスと言うことができます。
エッチングプロセスは微細加工(マイクロメーター~ナノメーター級の加工)が可能であり、半導体、フラットパネル(ディスプレイ)、MEMS、光学デバイス等、様々なデバイス製作工程において、必要不可欠なプロセスです。
- ➢イオン密度はイオン源のプラズマソースで制御し、イオンエネルギーは、グリッドのDC加速電圧(DC電圧供給による負Bias電圧)で制御します。従って、各々独立に制御可能です。
- ➢~0.1Torrの低圧力(RIE装置と比較して1桁低い圧力)でプロセスを行うため、イオンの平均自由工程が長く、衝突によるエネルギーの損失も少ない。
- ➢高加速電圧(>1kV)によって、エッチングレートは10˜30nm/min程度が得られます。
- ➢RIEではエッチングできない材料(エッチング反応生成物が揮発しない材料)でも使用する事が可能で、銅(Cu)、ニッケル(Ni)、金(Au)等の材料のエッチングにも使用されます。また、イオンビームエッチング装置は、「斜め回析格子のエッチング」にも使用されます。
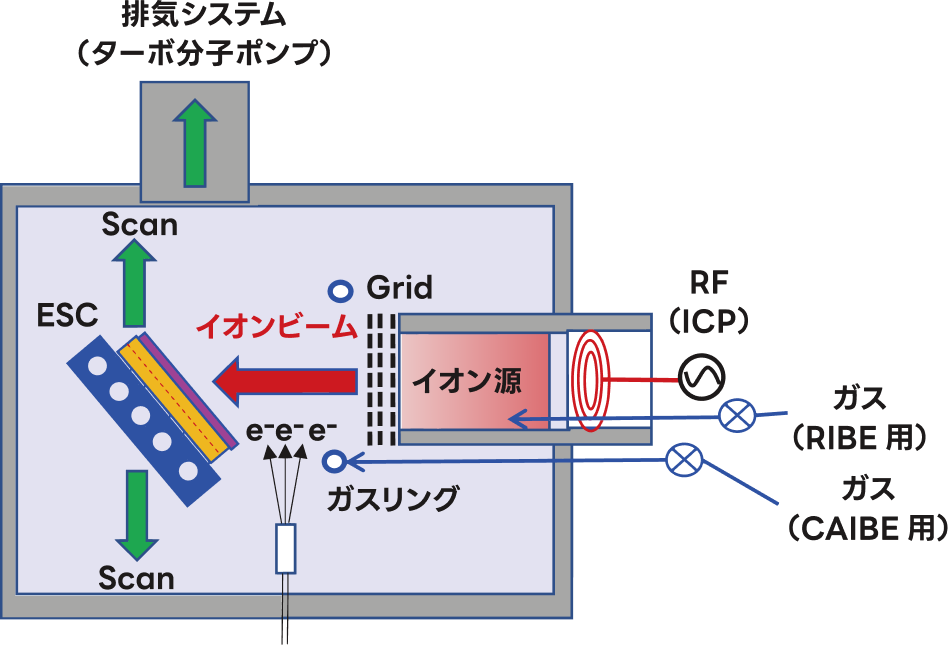
イオンビームエッチングプロセスの分類
・ RIBE(Reactive Ion Beam Etching):
反応性イオンビームエッチングの略。 反応性ガスは、イオン源のプラズマチャンバー内に、Arガスと共に導入され、イオン化された後、グリッドで加速され、反応性イオンビームとして基板に照射します。
・ CAIBE(Chemical Assisted Ion Beam Etching):
化学アシストイオンビームエッチングの略。反応性ガスは、イオン源より下流の反応室に導入され、イオン源からのArイオンによるイオン衝撃と、反応性ガスによる化学反応によってエッチングを行います。
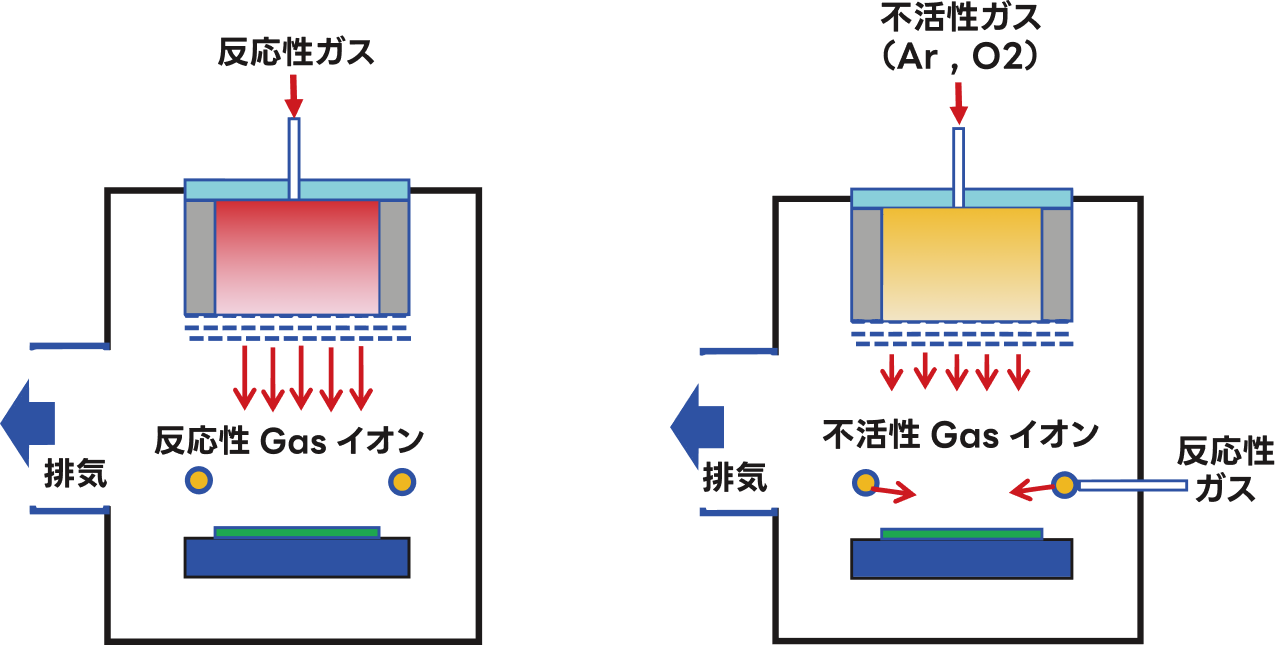
各エッチングにおける反応プロセスの違い
・ケミカルエッチング:
フリーラジカル(活性種)が被エッチング材料と反応してエッチングを行う。
(例)高圧反応性ガスエッチング
・物理エッチングやスパッタエッチング:
イオンがその場の電場(自己バイアス等)で加速されて、被エッチング材料に衝突して、物理的にエッチングを行う。
・イオンアシストエッチング:
ケミカルエッチングと物理エッチングのコンビネーションで、他の単独のエッチングプロセスより高速のエッチングが可能です。

エッチングガスと反応副生成物
エッチングで使用するガスは、ガスと対象膜のエッチング反応生成物の蒸気圧温度が低いものを選択します。
蒸気圧温度が高い場合、エッチングされた反応生成物が気化せずに堆積されて、エッチング反応が阻害され、また、処理室内部(処理室壁やICP石英板等)に反応生成物が付着・堆積して、パーティクルの発生要因となります。
表1. 各種エッチング材料と使用するガス
| エッチング材料(対象膜) | 使用するガス(例) | 反応副生成物 |
|---|---|---|
| Si | CF4, SF6 | SiF4 |
| SiO2 | CF4, CHF3, C4F8 | SiF4, CO2, CO, |
| SiC | SF6, NF3 | SiF4, CFx |
| Al | Cl2, BCl3 | AlCl3 |
| Cr | Cl2 | CrCl3 |
| MO | SF6, Cl2 | MoF, MoCl3 |
| Ti | Cl2 | TiCl4 |
| ガラス | CF4, SF6 | SiF4 |
| サファイアガラス | Cl2, BCl3 | AlCl3 |
| イオンアシスト | Ar |
表2. 各種材料のハロゲン化合物の融点と蒸発温度
| 材料 | ハロゲン化合物 | 融点 [℃] | 蒸発温度 [℃] |
|---|---|---|---|
| Al | AlF3 | 2250 | 1276 |
| AlCl3 | 192.6 | --- | |
| AlBr3 | 97.5 | 255 | |
| Si | SiF4 | -90.2 | -86 |
| SiCl4 | -68.85 | 57.65 | |
| SiBr4 | 5.2 | 154 | |
| Ti | TiF4 | 284 | --- |
| TiCl4 | -25 | 136.45 | |
| TiBr4 | 39 | 230 |
エッチングの重要なファクター
エッチング速度は、(エッチングされた膜の厚み)÷(処理時間)で表され、単位は、[nm/min]や、[Å/min]が一般的に使用されます。
エッチング速度は、反応性ガスの種類や、基板へのイオン衝撃の強さ、処理圧力、プラズマ密度等のプロセス条件によって変わりますが、一般的には、エッチング速度が速くなると、他のファクター(例:エッチング形状、エッチング選択比等)も変化する為、全てのファクターを総合的に見て、処理条件の最適化を行います。
(2)エッチング形状の制御(テーパー角度)エッチング形状(テーパー角度)の制御はプロセス条件により調整します。


[エッチング選択性]
エッチング対称物層ではない下地基板層とレジスト・マスクはエッチングされないことが望ましいが、いつでもその理想がかなう訳では有りません。
エッチング対象物層、下地基板層、レジスト・マスクがそれぞれ有限なエッチング速度 Ro, Rs, Rm を持つ場合には、そのエッチングの選択性(選択比)Ss, Sm が次のように定義されます。(これは等方性、異方性には拘わりません。)
下地層との選択比:Ss = Ro / Rs
マスクとの選択比:Sm = Ro / Rm
・エッチングの面内均一性:ウェハー面内の複数ポイント(中央/ミドル/Edge)のエッチング速度を測定して、均一性を算出します。
一般的なエッチング均一性の算出方法
エッチング均一性(U%)= {(最大値)-(最小値)}/{(2×平均値)}
